Reaktiv jonetsning
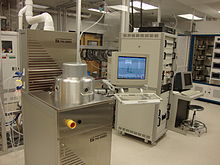
Reactive-ion etsning ( RIE ) är en etsningsteknik som används vid mikrotillverkning . RIE är en typ av torretsning som har andra egenskaper än våtetsning . RIE använder kemiskt reaktiv plasma för att avlägsna material som avsatts på wafers . Plasman genereras under lågt tryck ( vakuum ) av ett elektromagnetiskt fält . Högenergijoner från plasman angriper skivans yta och reagerar med den .
Utrustning
Ett typiskt (parallell platta) RIE-system består av en cylindrisk vakuumkammare, med en skiva placerad i bottendelen av kammaren. Waferbrickan är elektriskt isolerad från resten av kammaren. Gas kommer in genom små inlopp i toppen av kammaren och går ut till vakuumpumpsystemet genom botten. Typerna och mängden gas som används varierar beroende på etsningsprocessen; till exempel används svavelhexafluorid vanligen för etsning av kisel . Gastrycket hålls typiskt inom ett område mellan några få millitorr och några hundra millitorr genom att justera gasflödeshastigheter och/eller justera en avgasöppning.
Andra typer av RIE-system finns, inklusive induktivt kopplad plasma (ICP) RIE. I denna typ av system genereras plasmat med ett radiofrekvensdrivet magnetfält (RF) . Mycket höga plasmadensiteter kan uppnås, även om etsningsprofiler tenderar att vara mer isotropa .
En kombination av parallell platta och induktivt kopplad plasma RIE är möjlig. I detta system används ICP som en högdensitetskälla för joner som ökar etsningshastigheten, medan en separat RF-förspänning appliceras på substratet (kiselskiva) för att skapa riktade elektriska fält nära substratet för att uppnå fler anisotropa etsprofiler .
Arbetssätt
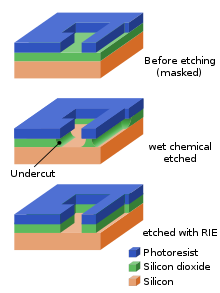
Plasma initieras i systemet genom att ett starkt RF ( radiofrekvens ) elektromagnetiskt fält appliceras på skivan. Fältet är vanligtvis inställt på en frekvens på 13,56 megahertz , applicerad på några hundra watt . Det oscillerande elektriska fältet joniserar gasmolekylerna genom att ta bort dem från elektroner, vilket skapar en plasma .
I varje cykel av fältet accelereras elektronerna elektriskt upp och ner i kammaren, ibland träffar de både den övre väggen av kammaren och skivan. Samtidigt rör sig de mycket mer massiva jonerna relativt lite som svar på det elektriska RF-fältet. När elektroner absorberas i kammarväggarna matas de helt enkelt ut till jord och förändrar inte systemets elektroniska tillstånd. Elektroner avsatta på skivan får dock plattan att bygga upp laddning på grund av dess DC-isolering. Denna laddningsuppbyggnad utvecklar en stor negativ spänning på tallriken, vanligtvis runt några hundra volt. Själva plasman utvecklar en något positiv laddning på grund av den högre koncentrationen av positiva joner jämfört med fria elektroner.
På grund av den stora spänningsskillnaden tenderar de positiva jonerna att driva mot skivan, där de kolliderar med proverna som ska etsas. Jonerna reagerar kemiskt med materialen på ytan av proverna, men kan också slå av ( förstoftande ) en del material genom att överföra en del av deras kinetiska energi . På grund av den mestadels vertikala leveransen av reaktiva joner kan reaktiv jonetsning producera mycket anisotropa etsningsprofiler, som står i kontrast till de typiskt isotropa profilerna för våtkemisk etsning .
Etsningsförhållandena i ett RIE-system beror starkt på de många processparametrarna, såsom tryck, gasflöden och RF-effekt. En modifierad version av RIE är djup reaktiv jonetsning, som används för att gräva ut djupa detaljer.
Se även
- Deep RIE (Bosch Process)
- Plasmaetsare
